搜索结果: 1-12 共查到“知识要闻 电子科学与技术 3D”相关记录12条 . 查询时间(0.214 秒)
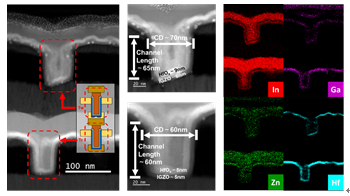
中国科学院微电子所在CAA结构的3D DRAM研究领域取得重要进展(图)
结构 器件 晶体管
<
2024/2/28
DRAM是存储器领域最重要的分支之一。随着尺寸微缩,1T1C结构DRAM的存储电容限制问题愈发显著,导致传统1T1C-DRAM面临微缩挑战。基于铟镓锌氧(IGZO)晶体管的2T0C-DRAM有望克服1T1C-DRAM的微缩挑战,在3D DRAM方面发挥更大的优势。但现阶段研究工作都基于平面结构的IGZO器件,形成的2T0C单元尺寸(大约20F2)比相同特征尺寸下的1T1C单元尺寸(6F2)大很多,...

中国科学院半导体所在2D/3D双模视觉处理芯片研制取得新进展(图)
芯片 工业机器人 电路
<
2024/2/28
二维(2D)和三维(3D)双模视觉信息在自动驾驶、工业机器人、人机交互等前沿领域具有广泛的应用前景。但是2D和3D两种模式视觉信息在处理方法上存在较大的差异,使得边缘端计算型处理器难以兼顾两种模式的处理需求;同时以深度学习为代表的人工智能算法的计算密集和高数据复用率等特点进一步增加了处理器电路的设计复杂度,导致边缘端实现双模视觉信息智能处理的芯片设计面临大的挑战。

上海微系统在超导3D纳米桥结的基础研究方面取得重要进展(图)
超导器件 纳米 电路
<
2023/12/3
最近,中国科学院上海微系统与信息技术研究所陈垒研究员、王镇研究员的研究团队在超导约瑟夫森结物理与电学表征基础研究领域取得了重要进展。研究团队通过微纳加工与测量表征技术相结合,成功实现了超导3D纳米桥结电流相位关系的精确测量,并揭示了约瑟夫森桥结的电流相位关系随着其几何尺寸缩放的变化规律,为进一步深入研究超导约瑟夫森结的物理与应用提供了有效的实验与分析表征方法。相关成果于2023年8月13日以题为“...

中国科学院微电子所在CAA新结构的3D DRAM研究取得创新进展(图)
晶体管 平面结构 器件堆叠
<
2023/8/21
随着尺寸的不断微缩,1T1C结构动态随机存储器(DRAM)的存储电容限制问题愈发显著,导致传统1T1C-DRAM面临微缩瓶颈。基于铟镓锌氧(IGZO)晶体管的2T0C-DRAM有望突破1T1C-DRAM的微缩瓶颈,在3D DRAM方面发挥更大的优势。但目前的研究工作都基于平面结构的IGZO器件,形成的2T0C单元尺寸(大约20F2)比相同特征尺寸下的1T1C单元尺寸(6F2)大很多,使IGZO-D...

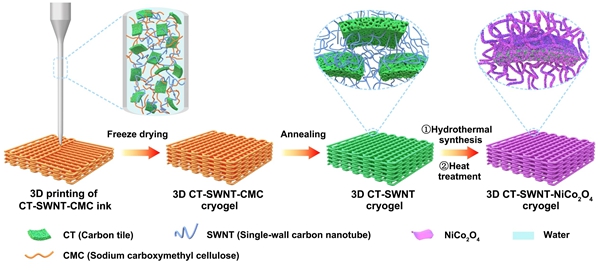

近日,中国科学院上海微系统与信息技术研究所陈垒研究员、王镇研究员提出了一种新型3D nano-SQUID超导存储器件,并发现利用其特有的偏离正弦函数的电流-位相关系,可以从原理上突破超导存储器的集成度瓶颈。研究结果以题为“Miniaturization of the Superconducting Memory Cell via a Three-Dimensional Nb Nano-Superc...
石墨烯气凝胶可直接3D打印了
石墨烯气凝胶 3D打印 能量存储 纳米电子
<
2015/4/24
美国能源部所属劳伦斯利福摩尔国家实验室的研究人员,日前用3D打印技术将石墨烯气凝胶微晶格直接打印出来。这种新型石墨烯气凝胶将为能量存储、传感器、纳米电子,以及催化和分选流程带来巨大好处。相关成果发表在4月22日出版的《自然・通信》杂志上。3D打印的石墨烯气凝胶具有高比表面积、优良的电导率、质量轻、有机械刚性且抗超级压力等特性。此外,这种产品在大规模石墨烯材料传质过程(体系中由于物质浓度不均匀而发生...
中国科学家自主研发出可打印人体细胞的3D打印机
中国科学家 自主研发 打印人体细胞 3D打印机
<
2013/8/8
来自杭州电子科技大学等高校的科学家自主研发出一台生物材料3D打印机。科学家们使用生物医用高分子材料、无机材料、水凝胶材料或活细胞,目前已在这台打印机上成功打印出较小比例的人类耳朵软骨组织、肝脏单元等。
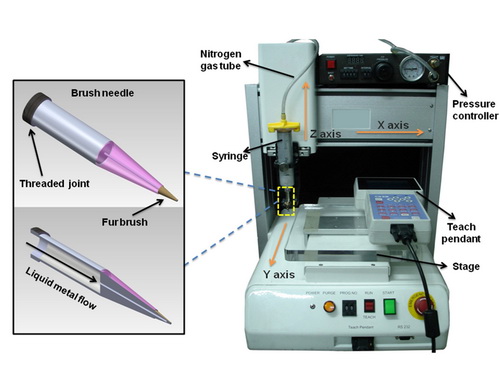
中国科学院理化技术研究所研制出功能电子电路桌面式3D打印系统原型(图)
功能电子电路 桌面式 3D打印 系统原型
<
2013/6/8
近日,中科院理化技术研究所刘静研究员带领的科研团队,继提出液态金属印刷电子学方法后,首次成功研制出了室温下直接生成纸基功能电子电路乃至3D机电器件的桌面式自动打印设备原型样机,为新技术向普及化推进迈出了关键的一步。文章发表在Nature出版集团系列期刊《科学报告》上(Zheng et al., Scientific Reports, 3: 1786, 2013),随即入选most-read art...
从PC开始3D激活显示技术革命
PC 3D 显示 技术
<
2011/10/31
阿凡达(Avatar)带起的3D热潮让这项已开发许久却始终欠缺临门一脚的显示技术快速跃居主流,也让3D影像处理成为今年度Computex展会的重头戏。从PC到电视,所有显示器都即将经历“3D化”的过程。


